行业现状与核心挑战
制程微缩
随着摩尔定律推进,缺陷尺寸进入纳米级,传统算法难以捕捉细微差异。
数据爆炸
晶圆检测产生海量图像数据,人工复判效率低下且存在疲劳误判。
实时性要求
整线检测要求在毫秒级内完成推理,以支撑产线全速运转。
设备整线AI检测架构
构建从边缘端(Edge)到云端(Cloud)的一体化检测生态,实现全流程闭环控制。
实时采集: 高速工业相机多工位同步抓取。
边缘推理: 分布式GPU阵列实现即时缺陷识别。
云端自学: 异常数据回传,持续更新检测模型。
全线联动: 结果直接反馈给EAP系统。
AI缺陷检测示意 (WAFER / AOI)
基于深度残差网络(ResNet)与视觉Transformer(ViT)的混合架构,实现高精度缺陷提取。

多尺度特征融合,能够有效识别包括裂纹、划痕、颗粒及色差在内的多种复杂缺陷。
模型训练架构与算法演进
全自动化训练流水线
自动超参数调优: 基于AutoML的贝叶斯优化。
对比学习: 解决少量正样本下的识别率问题。
模型压缩:TensorRT加速,确保边缘侧推理低延迟。
知识蒸馏:将大型教师模型的精度迁移至小型端側。

数据标注与样本生命周期管理
主动学习 (Active Learning) 流程
通过智能筛选“难样本”,将人工标注量减少 70%。流程如下:

半导体 / 晶圆检测典型案例
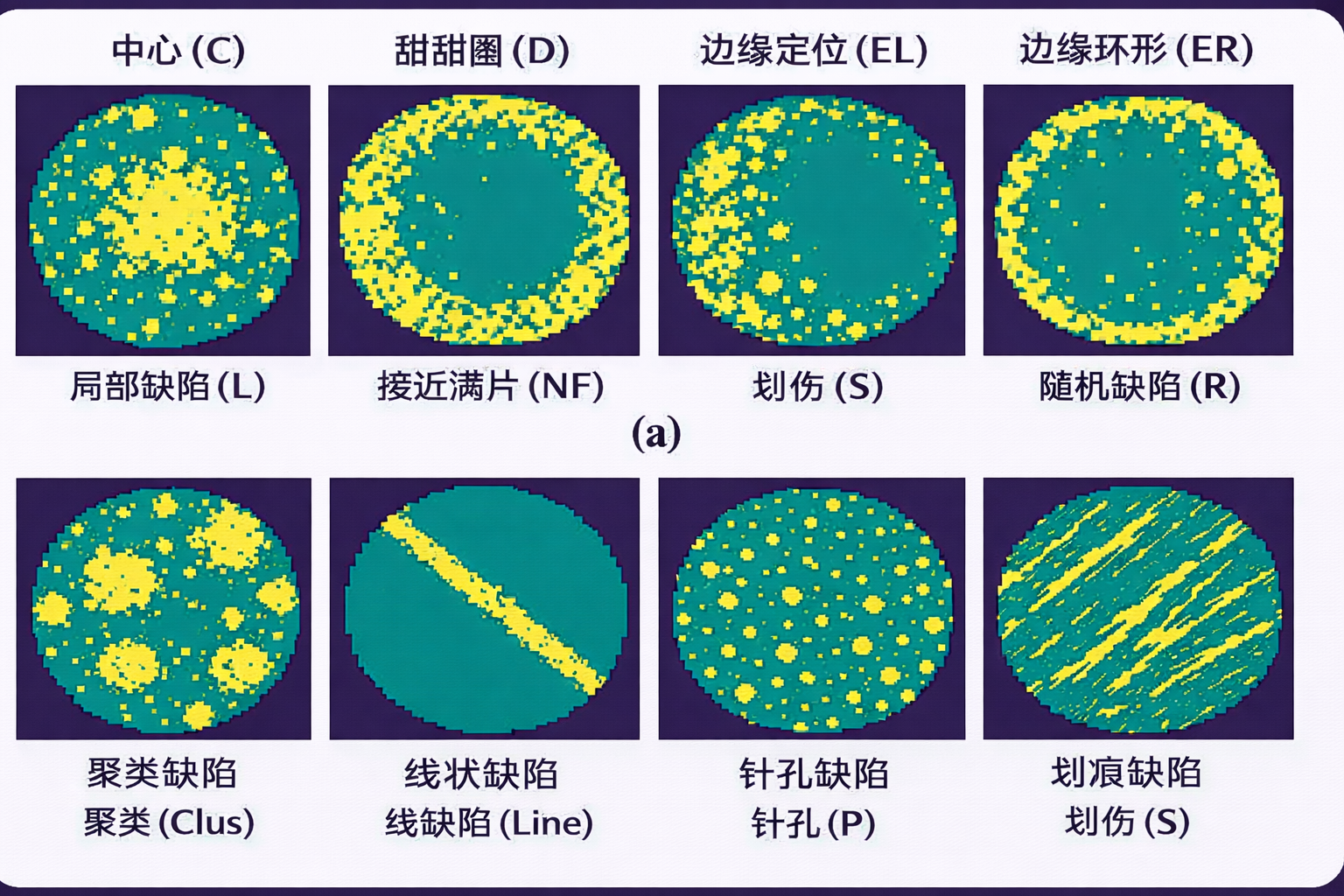
微裂纹 (Micro-Crack)
检测精度达到500nm级,漏检率 < 0.1%。
ROI 投资回报与效益分析

长期核心价值:
缩短爬坡期:快速积累新制程检测经验。
一致性保障:消除人工检测的主观差异。
预防性维护:通过缺陷分布预测设备健康。
投资回收: 预计在12-18个月内实现盈亏平衡。
传统算法 VS. 智能化AI检测
评价指标 | 传统视觉算法 (CV) | 智能化AI模型 (Deep Learning) | 提升幅度 |
缺陷召回率 (Recall) | 85% - 92% | 99.5% + | ~8% |
过检率 (Overkill) | 5% - 10% | < 0.5% | 显著下降 |
新缺陷适应时间 | 2-4 周 (人工调參) | 2-3 天 (在线迁移) | 提升 90% |
检测速度 | 中等 | 极高 (硬件加速) | 3x - 5x |
模型上线与持续迭代路径

赋能半导体“零缺陷”制造
AI不仅仅是更快的检测工具,它是贯穿整个制造生命周
期的智能化中枢,是通向未来"黑灯工厂"’的核心底座。
 苏ICP备2026006820号-1
苏ICP备2026006820号-1